钽电容生产工艺与钽电容器的故障模式关系
钽电容器的故障模式的讨论基本包括两方面:标准二氧化锰负极类型和新导电聚合物(CP)类型。标准钽电容器在正常工作模式下,由于电脉冲和电压水平,使沟道(通道)中电导增加,而导致电击穿。这会导致随后的热击穿,将电容器击毁。在相反模式下,我们已经通报过:在相对低的电压水平下,焦耳热会引起导电增加,从而触发热击穿。最终导致反馈循环,包括:温度-电导 -电流-焦耳热,最终形成电击穿。这两种击穿模式具有随机特征,很难提前定位。相对于标准钽电容器而言,导电聚合物(CP)电容器则显示了稍微不同的电流导电机理。导电聚合物的介质击穿近似于雪崩击穿和场致发射击穿。是由于两电极之间的引力,电化学衰变,枝状结晶组织等原因导致的机电崩塌。然而,也出现了某些负极膜发生自愈现象报告。这可能源于膜蒸发,碳化和再氧化过程。但并非所有的电容器击穿会导致自愈现象或开路状态。可能也会出现短路情况。
我们对于介质击穿的研究意在找出可以对这种现象加以描述的基本参数系列,及其与最终产品的质量和可靠性之间的关系。基本上,介质击穿可由一系列的物理过程产生:焦耳热引起电导增加,从而导致热击穿;雪崩击穿和场致发射击穿;两电极之间的引力,电化学衰变,枝状结晶组织等原因导致的机电崩塌 等等。介质击穿导致绝缘体和两极的击毁,主要由于熔化和蒸发和有时随后发生热逃逸。为掌握钽MIS(金属-绝缘体-半导体)异晶结构的更多数据和找到与介质击穿之间的关系,我们研究在两中模式下的电流/电压依赖工作参数(在正常模式下,钽电极被施加正偏压;在相反模式下,钽电极被施加负偏压)。
击穿击毁不仅源于突发的击穿情况,而且由于随后的电流流动,从而使击穿的起源和动力难于解释。
当自愈情况出现时会出现一些特殊现象。在某些 情况中,薄弱点和体击穿面积可以减少。在实验室实验中,热击穿可以被测量,而元件装置不被毁坏;电击穿可以被观测到,而只出现最小的损坏。辅助自愈过程也可以被推导出;氧元素可从二氧化锰负极中释放出来,允许钽二氧化物的再生或消除电子陷阱(类似于阳极化处理或钝化过程),使在介质层中的薄弱点减少。
根据报告,导电聚合物材料有两种自愈途径。第一个理论基于蒸发过程。聚合物的熔化和蒸发温度相当低。如电流错误足以使聚合物加热,则其可蒸发和消除掉其与该处的联系。
自愈的第二个理论则认为当导电聚合物在故障处被加热时,聚合物吸收氧元素,从而形成一个高电阻帽,封住了电流向该故障处的通路,与二氧化锰 MnO2 的自愈方式大致相同。
介质层的击穿过程并不十分确定。我们的薄氧化膜实验表明电击穿并不在施加电场的定义值精确(高)时出现。击穿过程是随机过程的结果,最终的击穿个案,多数情况下都为独立事件。
实验
击穿过程的识别,无论是热击穿或是电击穿都可由 V-A (电压/电流) 涵数加以在时域内的测量确定出。[2], 在如上定义的正常模式和反的模式条件下。在这些实验里,装置必须与电源和一系列电阻力小于装置电阻的电阻连接在一起。这些电阻经过实验性地选择,以防止被连续击穿和击毁,范围从 10Ω 至 1MΩ.之间。
击穿试验用于分析二氧化锰 MnO2 和导电聚合物技术的自愈过程。采用逐渐增加电流方法递增电压加载,直到电击穿出现为止。电容器对击穿故障点的自复/自愈能力用(电)压减降方法和 IR(红外)摄影机监测。
二氧化锰 MnO2正常模式下的电流传送
电流在正常模式通过MIS异晶机构的通过情况 ( 本例为Ta-Ta2O5-MnO2 / 钽-五氧化二/二氧化锰系统)已在诸多论文中报告过 [例如:见 3,4]. 因此,我们只考虑物理结构和传送的基本原理. 电荷在正常模式下按照 Poole-Frenkel 和 Schottky 作用原理通过钽电容器。可以设想电荷从二氧化锰电荷水平隧道式穿过五氧化二钽Ta2O5介质层的层间障碍。 五氧化二钽Ta2O5 内的电场助长电荷从电子陷阱内的释放,假定电荷以较低迁移率从一个陷阱跳到另一个陷阱。 Schottky 效应通常被认为是层间效应,而 Poole-Frenkel 效应则被认为是体(负阻)效应。
可以首先确定,电击穿是以不定时间和不定位置出现在高电场内。
在反模式下电流的传送
我们曾经研究过几种类型的电容器和钽电容生产厂家的负动态电阻和特定的串联电阻(见例图1)。

图1. 在反模式下的MnO2 (二氧化锰)钽电容器中的V-A 涵数曲线。
至少有4种不同的作用原理帮助我们解释负动态电阻的出现:
i) 场诱导导带电荷的迁移从低能量,高迁移率区域至较高能量,低迁移率的卫星(外围)谷 (Gunn effect/耿氏效应)
ii) 隧道
iii) 形成高电流
iv) 双注入
在该个案中, 我们认为电流的不稳定性控制了动态电阻,这种现象或是由于偶然噪声波动,或是由于不统一搀杂而造成,且与载流子热激励有关。该效应依赖于温度,在装置内会发生局部加热。这将依次导致导电率的改变。该不稳定性与电噪音相关。 辅助的噪音测量会使我们对该现象的起因更加明了。
钽电容器总的来说是金属 – 绝缘体 – 半导体异晶组织 (MIS 二极管) 。 反模式 (MnO2二氧化锰负电极被施加正偏压,同时钽正电极被施加负偏压)相当于 正向作业的MIS二极管 , V-A 涵数曲线表现其指数关系。图1, 对于小于热击穿电压 VTB, 的电压,V-A 涵数在低注入区域被指数曲线接近。零动态电阻出现时的电容器热击穿电压 VTB ,视其样品历史和所采用的技术。样品温度会与电流同时增加,当电流达到120 mA 时,温度则会升到 100°C 。
如在高电压条件下或装置的内部有疵点 ,电流不会均匀地在电容单元体内分配,通道内会出现高密度电流。这是由于温度 - 电导 - 焦耳热 - 升温循环反馈。焦耳热造成的高电流密度通道显示出某种稳定性,反模式条件下的 V-A 动能依赖特征可能是由于长时持续加温。
电击穿
对在钽和铝上生成的薄氧化膜的研究提供了电击穿[2]的有关数据。击穿事故发生率随时间减低到一个稳定值。当击穿电压被接近时,击穿发生率增加。随着电压的增长,装置因在某个疵点发生的热逃逸而发生故障的机率也增加。击穿电压依赖于脉冲的持续。在某些实验中,可以看到击穿电压随着脉冲长度的增加而降低。该过程不是十分确定的;击穿以不定时间间隔出现在不定位置。在反模式下,电击穿是由于焦耳热产生的热击穿的最终状态
导电聚合物在正常模式下的电流传导
V-A 涵数曲线的第一部分(见图3)可以被描述为平方律关系曲线,与电流注入(电子陷阱-嵌层-极限)绝缘层相关。
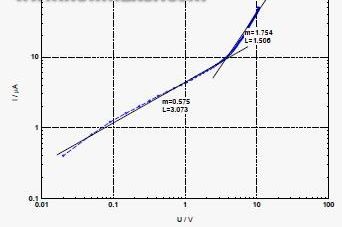
图2. 正常模式下带导电聚合物的钽电容器
第二部分为二次方关系线,由于空间电荷以统一的电子陷阱分布限制了电流注入。两个过程之间的转折点依赖于Fermi 费米能级有关陷阱击活的能量。Poole-Frenkel 作用原理与空间电荷限制电流注入绝缘层一致。电场密度并不是均匀的,在接近注入电极处相当高。因此对负极材料的要求标准则显得至关重要。
电流在反模式下的传导
导电聚合物技术不对带特定串联电阻的负动态电阻进行监测 (见图 3)。这是因为经过介子层在高电流密度沟道中的温度 – 电导 – 焦耳热 – 温度增加循环的反馈,因为在反模式下的转折作用过程与介质层表现明显呈正比,所得结果应该是一致的。由于负极材料不同的功能,另一差别存在于击穿电压的低水平。

图3. 反模式下带导电聚合物的钽电容器
导电聚合物的击穿
不同的 CP(导电聚合物)生产商技术的报告之间有明显的不同。采用第一种技术的电容器显示在击穿发生时,没有任何自愈过程的记载,而且在介子层被击穿后,即发生短路。第二种技术的个案中则没有发现任何一例击穿电压。在测试中,电流持续增长直到发生热击穿为止,未观察到任何自愈现象。

图4. 采用第一种技术的导电聚合物,介质层被击穿造成短路
结论
根据 V-A 涵数, 采用MnO2 /二氧化锰或导电聚合物制造的固体钽电容器可被当作一种 MIS (金属-氧化物-半导体)二级管,并且其反模式与正向作业的 MIS 二级管一致。
如采用 MnO2 /二氧化锰作为负极材料,在正常模式下的热击穿会因能量损耗而伴随电击穿。然而,在反模式下,焦耳热会产生电导的增加,而导致击穿发生。正反馈循环然后发生:温度-电导-焦耳热-温度升高。
在另一方面,导电聚合物电容器的V-A 涵数,具有第一部分,低密度区域,被描述为正方律关系(曲线)。其与电流注入绝缘层(陷阱-嵌层-极限)关连。由于空间电荷的统一陷阱分布对电流注入的限制,最终伴随二次方关系(曲线)。
在 25 – 35V(三倍额定电压)测试电压条件下引发的MnO2 /二氧化锰电容器的电击穿 导电聚合物介子层击穿出现在较低电压 10 – 20V (一至两倍于额定电压)。
在电击穿实验中,MnO2 /二氧化锰部件被证明比经过实验的任何一种导电聚合物技术具有更强的自愈能力。在测试中,未发现足够的自愈过程来支持导电聚合物材料具有自愈能力的论点。为了解导电聚合物材料的物理特性和潜在用途,还需要做进一步的工作。
热击穿
在正常工作模式下的受控制热击穿会对薄弱点增加自愈修复的机会,并减少局部疵点区的生成。
另一方面, 非控制下的热击穿会造成短路, 导致热逃逸而彻底摧毁电容器。

图5. IR (红外)摄影机监视下的自愈过程
在反模式下, V-A 涵数 会按指数达到最大的电压,在该点其进入负阻区间。
我们的实验显示, 对于小串联电阻 (~10 Ω) ,电压接近 VTB,时,热击穿和电流流动会使装置不稳定而在正模式下更趋近于热击穿。与该故障作用原理相关的电流,较比在薄弱点出现的较小的,与单点故障有关的值域,更具有更确定性。
本文编辑钽电容生产厂家-松填科技(www.sont.cc)技术部